関連記事
ディスコ、SiCインゴットのスライス加工 完全自動化でスループット半減
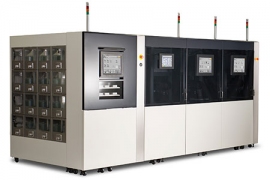
KABRA!zen SEMICON Japan 2017出展機(写真:ディスコのプレスリリースより)[写真拡大]
半導体製造装置メーカーのディスコは11日、レーザ加工によるインゴットスライス手法・KABRA(カブラ)プロセスの完全自動化を実現する「KABRA!zen(ゼン)」を開発したと発表した。SEMICON Japan 2017(13日~15日)に参考出展した。
【こちらも】CEATECアワード2017決定、IoT/AIが生み出す近未来を実感
●SiC半導体とは
SiC(シリコンカーバイド)は、シリコン(Si)と炭素(C)で構成される化合物半導体である。電車、ハイブリッド車、太陽光発電、エアコン、パソコンなどのパワー半導体では、Siに代えてSiCを用いる方向だ。Siに比べて、省エネや電力変換器の小型化ができるからである。
・小さいオン抵抗:電力損失の低減
・高温での動作 :冷却機構の小型化
・高速動作が可能:周辺回路の小型化
といったメリットがあげられる。
●KABRA(カブラ)プロセスとは
従来、SiCインゴットからウェーハを切り出すのに、ダイヤモンドワイヤソーを用いていたという。この加工は時間がかかるのみならず、切断部分の素材ロスが大きくて、取り枚数が少ないといった課題があったという。
このダイヤモンドワイヤソーに代えて、レーザを用いたのがKABRAプロセスだ。
・レーザ照射でインゴット内部にKABRA層を形成
・剥離、ウェーハ化。指定厚仕上げ研削へ
・次のレーザ照射のためにインゴット上面を研削
このカブラプロセスの生産性向上は絶大であり、次のような効果が見られた。
・ウェーハ1枚当たりの処理時間は、216分から25分と約1/10に
・うねりがなくなったことにより、ラップ研削工程16時間が不要に
・素材ロスの減少より、ウェーハ生産枚数が1.5倍に増加
●SiCインゴットスライス(ディスコ、「KABRA!zen」)のテクノロジー
今回の発表は、KABRAプロセスを完全自動化した点だ。今までは、KABRAプロセスの工程間でオペレータの介在が必要であったという。加えて、オペレータのスキルが全体のスループットにも影響していたという。
工程間の完全自動搬送によりスループットは半減したという。
EV化や省エネの需要は大きく、今後もパワー半導体へのSiC適用は加速していくと思われる。そのような中での製造工程の生産性向上は多くの引き合いがあるのであろう。
既に大手SiCウェーハメーカーの引き合いを受けており、2018年中のテスト出荷を目指す計画だ。(記事:小池豊・記事一覧を見る)
スポンサードリンク
